圖1.9是最早將邏輯IC以裸晶方式封裝所形成的漢子辨別卡,這個產品自1992年開始出貨,這張卡除了直接封裝裸晶之外,也有一些表面黏結元件和一般插入元件。
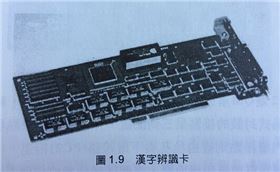
為了讓裸晶封裝制程可以廣泛地應用,可以將裸晶封裝部分設計成準模組的形式,使得裸晶封裝變成一般標準化的制程。使用裸晶封裝的增層電路板可以回溯到這張卡。圖1.10是電路板的橫截面,基本上和圖1.7的橫截面相同。增層電路板的絕緣層厚度由FV1以下線路的銅表面到上面線路的銅下面為40um,FV2為80um。由于FV2的厚度是FV1的兩倍,因此栓孔的孔徑較大。照片是FR4的基層部份,由于照片中可以看出玻璃纖維布纖維編織的情形。圖1.11是封裝兩個裸晶部份的放大照片。晶片尺寸為12.7mm見方,覆晶式接點數目為351.晶片周圍,由晶片接點引出到基板一般導線的部份主要是作為QM的測試接點。

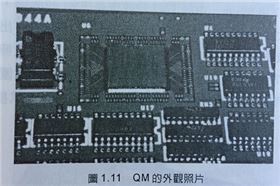
圖1.12是QM基板部份的掃描式電子顯微鏡照片,較亮的部份是銅。覆晶片封裝的接點呈三列配置,外側兩列的接點與表面線路相連,最內層接點則經由栓孔與下層線路相連。中央部份較大的銅區域為電源層和接地層,這個區域分割成幾個不同區域分別與電源和接地的接點連接。電源層和接地層也都和QM部份連接。

圖1.13是覆晶式封裝的接點照片。比較特別的是與晶片連接的外接點形狀是由防錫漆開口部份所定義。由于覆晶片接合部份的可靠性會受焊錫量多寡的影響,利用這個結構即使防焊漆稍微偏離位置,接點面積幾乎不會改變,因此可以控制接點上的焊錫量。一般的矩形覆晶片封裝接點在接合部份的角落位置容易產生應力集中,因此最好改用圓形。但是如果利用樹脂固定的覆晶式封裝時,為了減少接合部份的偏移所以最好使用可以控制接合部份焊錫量的矩形接點。圖1.13中的晶片是以覆晶式封裝在36mm見方的PGA基板上。36mm見方大小的PGA基板尺寸是晶片的3倍大。因此如果直接以裸晶封裝的話封裝尺寸可以大幅縮小。


 汽車BMS板
汽車BMS板 醫療設備FPC
醫療設備FPC 通訊功放 PCB
通訊功放 PCB 汽車傳感器板PCB
汽車傳感器板PCB