SiP(System in Package,系統級封裝),就是將多個具有不同功能的有源電子元件與可選無源器件,以及MEMS,或者光學器件等其他器件優先組裝到一起,實現一定功能的單個標準封裝件,形成一個系統,或者子系統。
從架構上來說,它會將處理器、存儲器、電源管理芯片,以及無源器件等不同功能的芯片通過并排,或者疊加的方式封裝在一起。它跟SoC一樣,都可以在芯片層面上實現產品的小型化和微型化。不同的是,SiP是將多顆不同的芯片封裝在一起,SoC是一顆芯片。
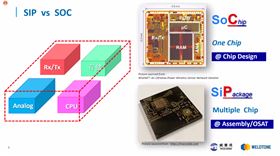
SiP與SoC架構的不同,圖片來源:電子發燒友
SoC是摩爾定律繼續往前發展的產物,而SiP則是實現超越摩爾定律的重要路徑。兩者各有優勢和劣勢,對SoC來說,它具有最高的密度、最高的速度和最低的能耗,但它需要對性能進行妥協、設計變更也不太靈活、開發成本高、開發周期也長、更重要的是良率會比較低;而對SiP來說,它可以選擇最好的元器件、設計變更更加靈活、開發周期短、開發成本低、良率也相對更高。

SiP與SoC的優缺點對比,圖片來源:電子發燒友
其實,汽車無線充PCB廠的集成電路的封裝技術一直在演進,其演進方向為高密度、高腳位、薄型化和小型化。集成電路封裝技術的發展路徑大致可以分為四個階段,第一階段是插孔元件時代;第二階段是表面貼裝時代;第三階段是面積陣列封裝時代;第四階段是高密度系統級封裝時代。
目前,全球半導體封裝的主流已經進入第四階段,SiP,PoP,Hybrid等主要封裝技術已大規模生產,部分高端封裝技術已向Chiplet產品應用發展。SiP和3D是封裝未來重要的發展趨勢,但鑒于3D封裝技術難度較大、成本較高,SiP,PoP, HyBrid等封裝仍是現階段業界應用于高密度高性能系統級封裝的主要技術。

 手機通訊副板
手機通訊副板 5G基站天線板
5G基站天線板 通訊服務器板
通訊服務器板 光模塊
光模塊